



SnI4和臭氧原子层沉积(ALD)生长的氧化锡薄膜的性质研究
介绍
原子层沉积SnO2薄膜从多个角度进行了研究。例如,锂离子电池的阳极[1]、气体传感器[2]、催化活性[3]以及太阳能电池中的稳定缓冲[4]或基底[5]层。当SnO2被认为是纳米结构或纳米复合层的组成部分时,可以发现更多的应用。ZrO2-SnO2堆叠层已被证明具有机械弹性和可磁化薄膜的性能[6]。sno2包覆的碳纳米管作为催化剂[7]和ZnO-SnO2作为功能复合材料在锂离子电池中的应用[8]。更近一篇来自2022年的综述文章列出了27种不同的前驱体组合,用于在原子层沉积(ALD)工艺中获得SnO2[9]。其中两种方法采用SnI4作为金属前驱体,O2[10-14]或H2O2[10,11,15]作为氧化剂。
在这两种氧源中,O2更可取,因为有了它,无氢过程是可能的,这意味着膜中的污染和残留物更少。O2工艺的另一个优点是每循环更大生长量(GPC)是H2O2工艺的三倍[10]。O2工艺的缺点是沉积温度相对较高,从400°C开始[10-14],在600°C左右达到约0.12 nm/循环的更大GPC[13,14]。到目前为止,还没有发表使用SnI4和臭氧的工艺。结果表明,用臭氧代替O2可使沉积温度降至225℃,提高GPC性能。作者的目的是提供一个全面的描述所述过程和所产生的薄膜。
实验
本文研究的膜是在低压流动型ALD反应器中生长的[16]。锡(IV)碘化,SnI4 (99.999%, Sigma-Aldrich),用作锡前驱体,在83°C下从反应器内半开的玻璃船中蒸发。采用氮气(99.999%,AS Linde气体)作为载体和吹扫气体。臭氧由O2 (99.999%, AS Linde Gas)产生,作为氧化剂,臭氧发生器浓度为220-250 g/m3。ALD工艺在100-600℃的温度范围内进行,研究了不同薄膜性能对沉积温度的依赖关系。其他实验在300℃下进行,因为在该温度下获得了更高的GPC,为0.27 nm/cycle。为了可视化膜的逐步生长,同时确定碘化物前驱体的更佳脉冲长度,首先使用石英晶体微天平(QCM)原位检查SnI4-臭氧过程[17]。QCM数据是用Q-pod石英晶体监测器(Inficon)在300°C的稳定反应堆温度下获得的。对于非原位测量的薄膜生长,SnO2的循环时间分别保持在5-2-5-5 s,顺序为:金属前驱体脉冲,N2吹扫脉冲,臭氧脉冲,N2吹扫脉冲。薄膜生长在硅(100)上,在生长之前经过清洗和蚀刻。
用x射线荧光光谱仪ZSX - 400(程序ZSX Version 5.55)测量薄膜的元素组成。利用GES5-E型光谱椭偏仪测量了薄膜厚度和折射率。椭偏数据采用柯西色散模型建模。晶体结构采用掠入射x射线衍射仪(GIXRD),使用Cu Kα辐射的SmartLab Rigaku x射线衍射仪,对应的x射线波长为0.15406 nm。
在固体研究终端站[19]的FinEstBeAMS光束线[18]上进行了x射线光电子发射和x射线吸收光谱(XPS和XAS)测量。XPS采用SPECS Phoibos150半球形光电子动能分析仪,总光谱分辨率为0.3 eV。通过测量样品光电流并将信号归一化为参考光电流信号,XAS在0.1 eV的光谱分辨率下在总电子产率(TEY)模式下进行,该信号来自位于光束线更后一个光学元件后面的干净金网。
结果与讨论
为了确定能更大限度地覆盖底物表面的蒸发器温度,以及相应的更大生长速率,研究了GPC对SnI4蒸发温度的依赖性。从图1可以看出,当蒸发温度达到约82℃时,薄膜GPC显著增加。因此,为了进一步的实验,我们将sn4的蒸发温度设定为83℃。

图1:SnO2薄膜GPC随sn4前驱体蒸发温度的变化关系。周期时间设置为5-2-5-5 s,序列为SnI4脉冲、吹扫、臭氧脉冲和吹扫。
在通过非原位测量测定薄膜厚度的同时,还实时监测了循环前驱脉冲和吹扫周期后薄膜的生长情况。原位监测有助于逐步生长过程的可视化(图2)。可以看到,顺序ALD循环的应用导致固体薄膜材料的连续生长,由任意单位的质量传感器信号表示。
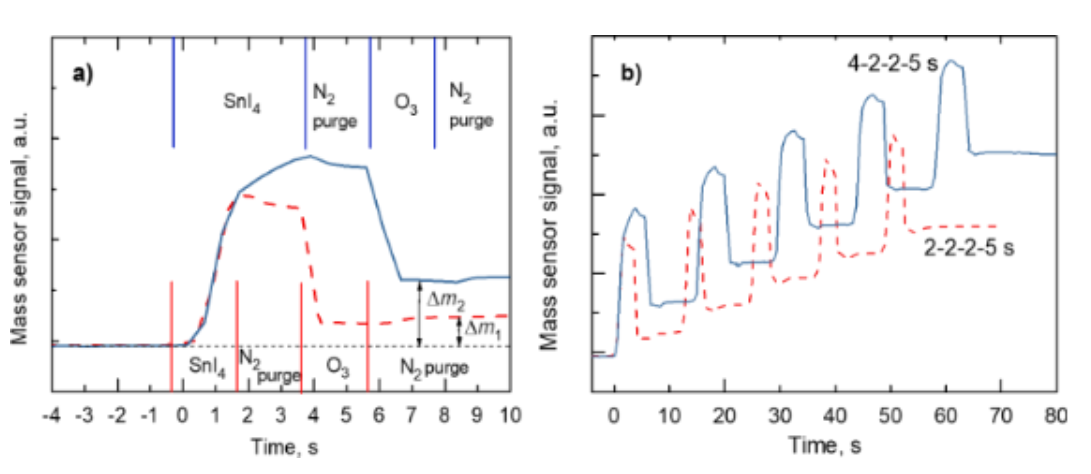
图2:QCM质量传感器信号在5个连续ALD周期(a)和1个ALD周期(b)中的时间演变。标记“4-2-2-5 s”和“2-2-2-5 s”表示SnI4、N2、臭氧和N2序列中的脉冲长度。∆m1和∆m2分别为脉冲长度为2-2-5和4-2-2-5 s的单次ALD循环后的质量增量。任意单位的质量传感器信号与QCM振荡周期的增量直接相关。
通过QCM监测薄膜生长,可以快速确定金属前驱体脉冲长度,以实现近自饱和吸附过程,并在单个周期内实现更大生长。然而,值得注意的是,由于QCM信号在任何金属前驱体暴露时间都没有完全稳定,而是继续增加,因此没有识别出金属前驱体的明确自饱和吸附过程(图2)。臭氧脉冲期间QCM信号的下降伴随着相对较重的碘的释放。氧化步骤完成后,QCM信号稳定(图2)。图3描述了振荡频率随SnI4脉冲长度的变化。后一种测试表明,5秒的SnI4暴露时间足以使吸附物质有效覆盖表面。以同样的方式,通过改变臭氧脉冲长度,得出更佳脉冲长度(此处未显示)。

图3:每个ALD周期测量的QCM频率衰减随SnI4脉冲长度的变化。SiI4脉冲之后的吹扫、臭氧和吹扫脉冲的长度分别为2、5和5 s。
改变ALD周期的数量表明,在ALD过程的早期阶段没有明显的潜伏期(图4)。

图4:SnO2薄膜GPC随ALD循环次数的变化。
薄膜的GPC在衬底温度为300℃时达到更高(图4)。显然,在任何温度范围内都不存在明显的饱和温度窗[20],即所谓的ALD窗。这可能与第一前体吸附过程中前体分子部分分解,同时配体即碘分子I2的释放加剧有关。此前,以TiI4和O2为前体,对ALD生长的TiO2薄膜进行了类似的研究[21]。似乎GPC在300℃时的初始升高是由于金属碘化物在接收表面的分解逐渐增强,而不是自饱和吸附过程。然而,在吸附步骤中,随着衬底温度的升高,更多的金属被添加到生长层中。因此,在金属前驱体脉冲后的吹扫期间,我们可以记录到本研究中(图2)吸附在表面的质量的减少,以及早期对TiO2的tii4基ALD的研究[21]。在前驱体脉冲期间吸附质量的减少可以用碘从表面的解吸来解释,随着温度的升高,其解吸速率增加。因此,我们有理由认为,在300°C以上,SnO2薄膜的GPC下降(图5)是由于表面碘化物与臭氧反应形成固体金属氧化物之前,I2解吸速率增加所致。此外,在更高温度(600℃)下GPC的明显增加可能是由前驱体的不受控制的分解引起的,也与沿气体流动方向的侧膜厚度剖面的增强有关。

图5:SnO2 GPC随衬底温度的变化。
对膜中氧和碘含量的分析表明,在衬底温度为200℃以上,氧含量保持稳定。在低于200°C的温度下,氧含量明显高于化学计量金属二氧化氮的预期含量(图6)。在碘含量上观察到类似的行为。在低于200°C的温度下生长的薄膜具有明显的高碘含量(图7)。当沉积温度高于200°C时,碘含量下降,而在高于300°C时,碘含量稳定在0.7-0.8原子%的相当低的水平(图7)。由于低于200°C的沉积温度下,相对较高的氧含量不是由于膜中的氧含量增加,而是由于锡含量减少,因此可以提出:在更低的沉积温度下,除了SnO2主体外,还形成了I2O5。因此,在低于200°C的情况下,很可能无法在此过程中实现功能SnO2薄膜。I2O5即使形成,在300℃以上的温度下也会分解[22]。在我们的研究中,碘和氧水平下降到足够低的值,在高于300°C的温度下获得化学计量SnO2作为主要相。

图6:SnO2薄膜中氧含量随衬底温度的变化。

图7:在100-600℃温度范围内,由碘化锡与臭氧沉积的氧化锡膜中残余碘的含量。
膜结构
随着沉积温度的升高,薄膜的结晶度增加,如图8所示。所有晶体薄膜的衍射图显示了四方SnO2的存在(PDF卡01-071-5324)。沉积从100°C开始进行;然而,在更低温度100-200°C下沉积的薄膜的XRD图没有在图8中描述,因为在225°C下生长的薄膜首先显示出可区分的反射。后者可能意味着在200°C以下沉积的薄膜中有很大一部分不是SnO2。当温度达到300℃时,样品在24.5°处存在一个衍射更大值,这不是SnO2相造成的。这是单斜晶I2O5的衍射更大值(PDF卡00-022-0338)。这与在较低温度下沉积的薄膜中测量到的较高的碘和氧含量是一致的。
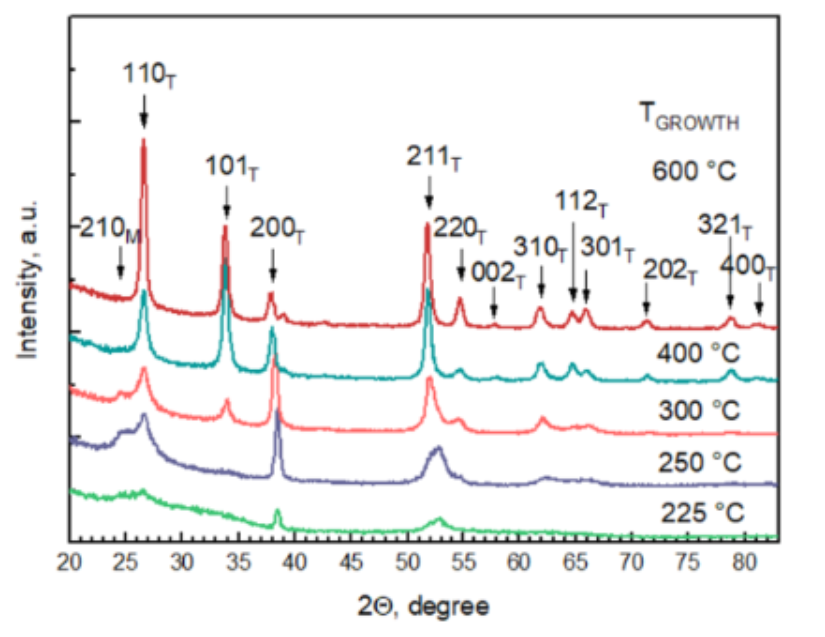
图8:在给定温度下沉积的SnO2薄膜的GIXRD图。图中表示了衍射更大值的米勒指数,其中T对应于SnO2的四方晶相,M对应于I2O5的单斜晶相。
在不同的沉积温度下,薄膜的折射率在整个样品系列中都是稳定的,在633 nm波长处,以SnO2为主的薄膜的折射率保持在2.04 ~ 2.06之间,残余很小。在300°C下沉积的薄膜的代表性色散曲线如图9所示。
![]()

图9:在300°C下沉积到110 nm厚度的SnO2薄膜的折射率随波长的变化。
折射率值约为。以双(1-二甲氨基-2-甲基-2-丙氧化物)Sn为Sn前体,H2O等离子体或O2等离子体为氧源,通过ALD生长SnO2薄膜,用椭偏仪测量了SnO2薄膜的形貌[23]。有一篇文章报道了以四(二甲氨基)锡为Sn前体,臭氧为氧源的SnO2热ALD的结果,得出的折射率值在2.0 ~ 2.1之间,与本研究的测量值相当[24]。本研究获得的折射率值超过了喷雾热解法沉积的SnO2薄膜[25],但仍低于通过连续离子层吸附和反应生长的生长后退火的SnO2薄膜[26]。
采用软x射线光谱法对300℃和500℃下生长的SnO2膜(即残余碘含量低的SnO2膜)进行了非原位表面化学分析。在300°C和500°C沉积的样品中,Sn 3d XPS数据(图10a)显示出几乎相同的光谱,窄的Sn 3d谱线轮廓表明形成了单相化合物。锡在其氧化物中可能存在的2+和4+电荷态只有很小的(约为1)。0.8 eV)的结合能差,小于两种化合物的线宽(FWHM≈1.2 eV)[27,28]。因此,对于混合相化合物,观察到的是整体谱线的不对称加宽,而不是出现额外的分解峰[27,28]。我们的数据中Sn 3d5/2 XPS结合能为486.9 eV,也与之前报道的SnO2化学计量学相吻合[27-34],表明我们的样品中存在单相Sn 4+化合物。

图10:300和500℃下沉积SnO2薄膜的XPS结果(a) Sn 3d, (b) O 1s, (c)价带区。
在1s XPS(图10b)中,530.7 eV的主导峰也与之前报道的SnO2的值很好地吻合[32-34]。令人惊讶的是,在较高沉积温度下获得的样品光谱显示,OH表面典型结合能的峰值更强烈(图10b)。这可能与环境湿度的化学吸附和分解有关,在更结晶的薄膜表面上增强。这种表面OH的贡献在之前已经被描述过[33,34]。
此外,价带光电子能谱(图10c)与SnO2[28]的报道非常相似,其优势峰略低于5 eV,在7.5和11 eV附近有进一步明显的特征。这与SnO价带形成了相当鲜明的对比,在SnO价带中,主要占据的Sn 5s态在约2.5 eV结合能处产生显著的峰值,而5ev的峰值并不占主导地位[28,29,35]。
另外记录x射线吸收光谱(图11),以检测样品之间的差异。Sn三维XAS波段由三维核心轨道到未占据的p和f对称态的跃迁构成,由光学(一阶)跃迁常见的偶极子选择规则定义(Δl =±1),而O 1s XAS探测氧的p特征态[36]。
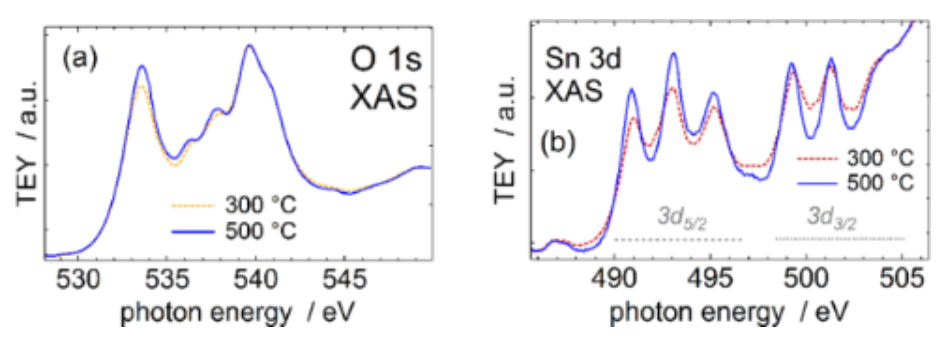
图11:XAS结果描绘了在300和500°C下沉积的SnO2薄膜的O 1s (a)和Sn 3d (b)光谱。
在sno2o1s XAS(图11a)中,更低的激发能峰(533.6 eV)被分配给了与配体Sn 5s杂化的未占据的o2p态,而在大约536.3、537.7和539.6 eV处的连续三个峰对应于与Sn 5p杂化的态[37,38]。在SnO2金红石结构中,由于配位八面体轴线的非等距配体和这些八面体的连接方向,后一种状态是非简并态的。我们注意到,SnO的任何更终贡献(即由于较低沉积温度下的不完全氧化[39,40])都将显示出完全不同的o1s吸收光谱,更低能量更大值下降约1 eV[28,29,35,36,41],并且在Sn 5p态对应的区域具有更宽且不那么强烈的特征,这对应于C4v对称的eg态分裂[37]。
在Sn3d XAS结果中(图11右图),Sn 5s态在从Sn3d核能级开始的跃迁中是偶极禁止的,而Sn 5p源在D2h配体对称中的三分裂b1u, b2u和b2u未占据态,导致Sn3d5/2区域约491,493和495 eV的三个峰(图11b)是SnO2的特征[28,29,37,39,41]。SnO2的Sn 3d谱与Sn 3d5/2的主峰有很大不同,激发能较低(约487 eV)[29,40,41],没有明显的三峰结构,而SnO2三重态的更高峰已经与SnO自旋轨道分量(Sn 3d3/2)主峰重叠。我们认为,相对于能量较低的3d5/2(491和493 eV)峰,495 eV峰的光谱形状稍微不那么尖锐,相对强度比略高,这表明在300°C沉积的样品中存在少量的SnO成分。或者,它只是一个结构不太均匀的样品,其中稍微变化的配体距离平均到不太尖锐的XAS峰。
由于在TEY模式下记录的XAS探针深度较浅(约10 nm),与记录的光电发射光谱(几个原子层)的高表面灵敏度相比[41],我们认为氧化程度较低的物质出现在膜的更外表面以下。
结论
在100 ~ 600℃的温度范围内,通过ALD将sno4和臭氧沉积成SnO2薄膜。当沉积温度超过225℃时,所得到的薄膜在SnO2的结晶四方相中形成,并且随着沉积温度的升高,薄膜中结晶物质的比例增大。在200°C和更低温度下生长的薄膜结构不有序,并且含有大量的残碘。此外,氧的分数也大于化学计量SnO2的预期分数。从大约300°C开始,本工作中应用和报道的前驱体化学为具有明确结构性质的SnO2薄膜提供了一条快速途径。膜的每周期生长约为0.25 nm/cycle。沉积温度可以低于使用SnI4和O2的工艺所需的更低400°C,并且每个周期的生长量大约是使用SnI4和O2的工艺的两倍。
来源
Institute of Physics, University of Tartu, W. Ostwaldi 1, 50411 Tartu, Estonia
Associate Editor: M. Nolan
Beilstein J. Nanotechnol. 2023, 14, 1085–1092. https://doi.org/10.3762/bjnano.14.89
Received 31 Jul 2023, Accepted 19 Oct 2023, Published 13 Nov 2023
联系我们
第一时间了解我们的新产品发布和最新的资讯文章。 北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企...
北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企... 您有什么问题或要求吗?
点击下面,我们很乐意提供帮助。 联系我们