



ALD过程中的步骤
原子层沉积类似于LPCVD,除了化学过程被分解成步骤,隔离不同的吸附和反应步骤,以进行自限制反应。该工艺采用前体和反应物的单独脉冲依次通过工艺室。
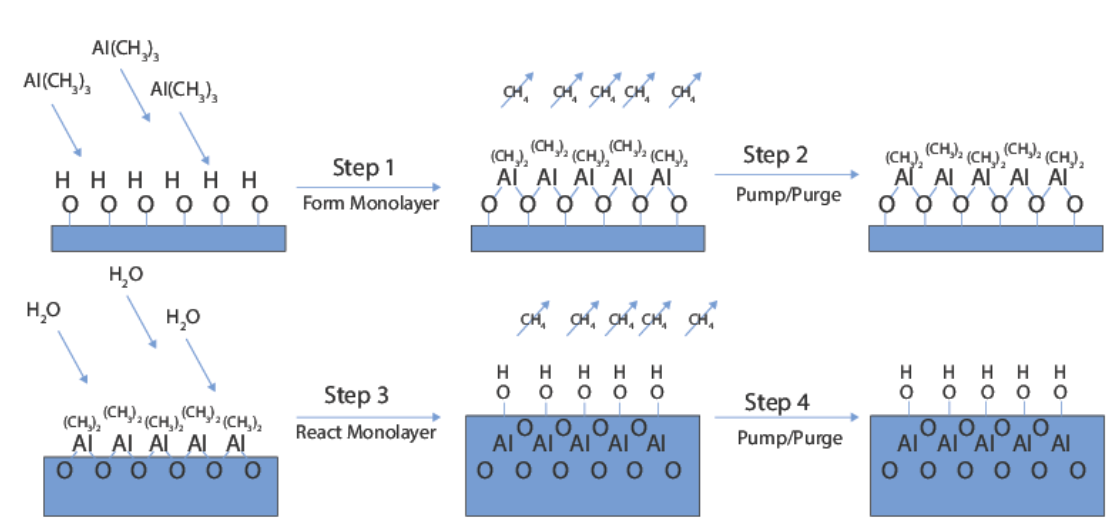
图1
图1说明了ALD过程。将基板置于工艺室中并在高真空下,将初始前驱体引入该工艺室。前驱体的分子特性是这样的,它将在衬底表面形成化学结合的单层(步骤1)。任何超过单层的层只受物理吸附力的束缚,这种吸附力足够弱,可以在高真空下将除单层中的任何前驱体抽走。一旦单分子层出现在基材上,则重新抽真空并清除室中多余的前驱体(步骤2)。接下来,将反应物引入工艺室(步骤3)。它与单分子层材料反应,在基材表面形成所需的化合物(步骤4)。该反应的副产物被抽走。
在代表性化学方面,考虑氧化铝的ALD过程。将铝烷基化合物脉冲,在本例中为三甲基铝,引入工艺室。未经处理的底物在ALD工艺之前已制备好,使其表面有有序的羟基覆盖,并且烷基铝与覆盖表面的羟基反应形成Al-O键,并通过CH3配体与表面OH基团之间的反应失去CH4基团(步骤1)。将其抽走,并使用快速惰性气体吹扫(步骤2)去除腔内的任何残留物。现在表面涂有Al-CH3,在这种情况下,将反应物(在步骤3中)引入腔内。它与Al-CH3键反应,产生更多的CH4气体,桥接Al-O-Al和Al-OH键。使用泵/吹扫(步骤4)将残留的CH4从系统中去除。桥接的Al-O-Al成为生长膜的一部分,膜表面的Al-OH呈现出新的羟基涂层表面,为ALD过程重新开始做好准备。
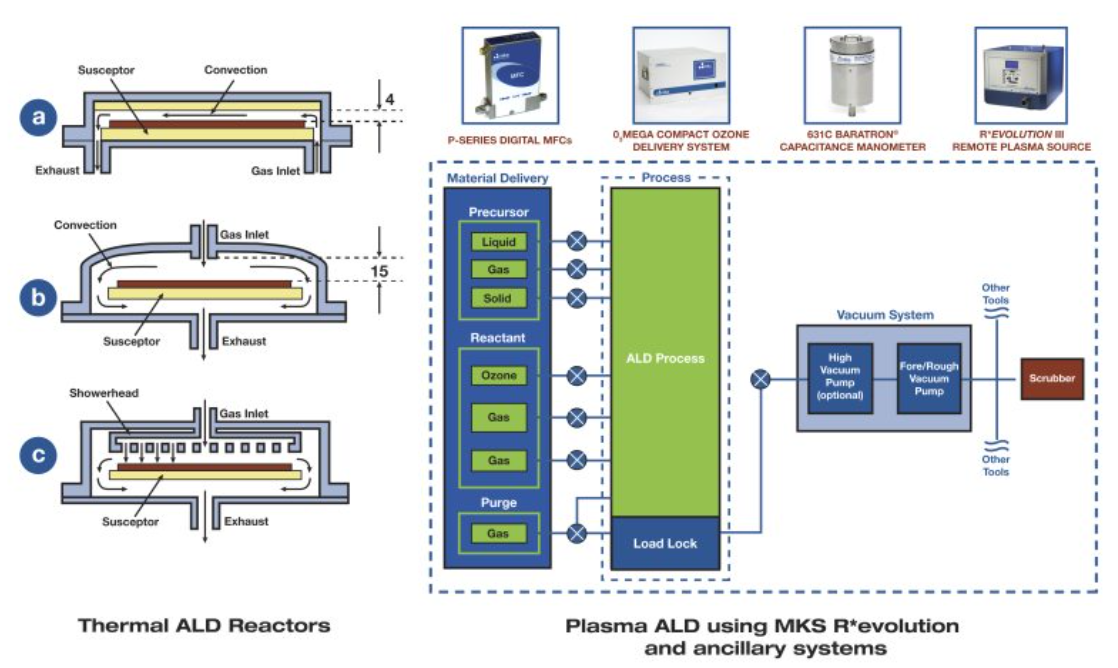
图2
因此,ALD处理需要非常苛刻和精确的有效前体输送和控制与过程和工具监控的结合。ALD过程由多个短周期步骤组成,采用多个前驱体作为非常小的、严格控制的气体脉冲传递。ALD加工的主要优点是它在大面积基底上产生完全均匀的薄膜,并且薄膜中具有完美的三维一致性。此外,控制单层的单层生长允许用户精确控制薄膜厚度。通过对前驱体和反应物的合理选择,ALD处理过程中的温度时间负荷可以保持在很低的水平。该工艺的主要缺点是其相对较慢的沉积速率,但这并没有被证明是其用于具有纳米尺度特征尺寸的设备的严重障碍。
ALD过程可以是热驱动或等离子体增强。使用直接等离子体、远程等离子体和直接/远程联合等离子体的等离子体增强ALD过程已得到证实。它们通常使用单晶圆集群工具设备配置进行。图2显示了不同类型ALD反应器的示意图。
联系我们
第一时间了解我们的新产品发布和最新的资讯文章。 北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企...
北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企... 您有什么问题或要求吗?
点击下面,我们很乐意提供帮助。 联系我们