



使用来自高纯度臭氧气体和乙烯气体的活性物质的新型低温成膜法
简介
近年来,在以有机电子为主的领域中,在耐热温度较低的薄膜上制作半导体器件的工艺以及为避免因热损伤而导致特性劣化的低温下的成膜需求不断增加。特别是在有机电子制造工艺中,由于底板耐热温度的限制,必须在80℃以下进行工艺。此外,室温下的成膜技术也备受关注,该技术可通过热退化极小化和加热能源损耗实现低成本成膜。在低温下的成膜中,需要替代热的化学反应源。例如,通过化学气相生长(CVD)在低温下形成氧化膜时,采用比氧“氧化力”更高的臭氧和等离子氧化的方法备受关注。臭氧气通常浓度在5%以下,但我们利用臭氧液化技术1)开发出浓度为~ 100%的臭氧气(以下简称高纯度臭氧气)发生装置,并应用于CVD。通过使用四乙氧烷(TEOS)或六甲基二硅氧烷(HMDS)作为原料气体的高纯度臭氧CVD,成功制备出250℃以上的优质SiO2膜2)。另外,在并用紫外光(波长带200nm—300nm)照射的高纯度臭氧CVD中,通过将臭氧分子的光分解反应产生的原子状氧应用于CVD工艺,成膜温度进一步降低,可在200℃下成膜3)。
本文介绍
使用由高纯度臭氧与乙烯气体反应的活性物质4)的CVD及原子层沉积(ALD),以使成膜温度进一步低温化,实现室温下的成膜。2.使用高纯度臭氧气体和乙烯气体的成膜工艺的特点本文中,由臭氧(O3)和乙烯(C2H4)反应产生活性物种的方法4)称为OER法(Ozone-Ethylene Reaction method)。使用由OER法产生的活性种,在CVD成膜工艺(OER-CVD)中,期待对臭氧分子无法进行反应的原料气体(有机金属气体)的分解反应以及之后形成氧化膜所需的化学反应起到促进作用。另外,在ALD成膜工艺(OER-ALD)中,有望对前体分子产生表面改性作用,形成吸附位点。在OER-CVD和OER-ALD中,为了提高活性物种的生成和供给效率,必须使用高浓度的臭氧气体。使用Fig. 1的臭氧浓度和抗蚀剂的提升率的关系进行说明。将OER有效地作用于抗压剂,在使用高纯度臭氧(~ 100%)时,即使在室温下也可实现~ 90nm/min.的抗压剂抗压剂的抗压剂。
另一方面,随着臭氧浓度的减少,压裂率急剧减少,臭氧浓度在50%以下时,压裂率为~ 0nm/min.,无法进行压裂。据推测,这是因为随着臭氧浓度的降低,活性物种生成量的降低以及失活反应的增多,为了抑制这些现象,在以下所述的OER-CVD和OER-ALD室温成膜中,必须使用高纯度臭氧。另外,众所周知,在高层大气等低压条件下,乙烯与臭氧的反应会生成OH自由基。
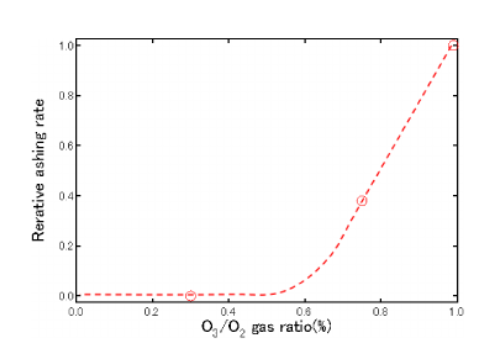
图1所示。臭氧浓度对规范化灰化速率的依赖性。在~100%氧化气体条件下,灰化速率约为90 nm/min。
因此,目前正在另外进行OER活性种的检测和鉴定。与O3相比,OH自由基是与各种有机物具有高反应速率常数的高反应性活性种。例如,在乙酸中,与OH的反应速度常数比与O3的反应速度常数大1011倍左右(8)。也就是说,低温工艺几乎不与臭氧进行分解反应,而可与OH自由基进行分解反应。如果在大气压条件下OER的活性种是OH自由基,则有望得到广泛应用,因此正在推进相关验证。

图2所示。oer - cvd装置原理图。臭氧气体和乙烯气体在气相沉积室中混合并供应给样品
Fig2描述了OER-CVD处理设备的配置。Fig. 2中,成膜的氧化膜以SiO2为目的,采用四乙氧烷(TEOS:分子式Si(OC2H5)4)作为CVD原料气体。另外,在形成SiO2膜以外的氧化膜时,通过将CVD原料气体切换到TEOS以外即可成膜。将高纯度臭氧(发生装置:明电舍MPOG系列)气体以及乙烯、TEOS、氮气的混合物气体提供给CVD反应堆。其中N2被用作TEOS的载体气体。另外,已知TEOS与乙烯气体不进行反应。CVD炉的目的是在处理基板表面附近生成活性物质并促进CVD反应,淋浴喷头型的气体供给方式采用了可在基板表面附近混合高纯度臭氧气体和含有乙烯气体的混合气体的方式(双淋浴喷头结构9))。作为气体供应顺序,可先供应~ 100%臭氧气体和乙烯气体,通过对底板表面(薄膜表面)进行表面处理,使表面改性变为亲水性10)。通过在改性后开始CVD成膜,可形成与基板表面粘附性高的SiO2。在实际的OER-CVD工艺中,先向底板供应一定时间的臭氧气体和乙烯气体,进行表面改性工艺,然后再追加供应TEOS气体和N2气体,过渡到成膜工艺。
总结
通过将通过混合高纯度臭氧和乙烯气体生成大量活性物质的技术(OER)应用于化学气相生长(CVD),确认了在室温下可生成SiO2膜的事实。一般来说,膜质有随着成膜温度降低而变差的倾向,而由OER-CVD制成的SiO2膜在室温下也具有与高温匹敌的膜特性。进一步将OER应用于原子层沉积(ALD),确认了在室温下可形成Al2O3膜。OER-CVD和OER-ALD很可能通过转换原料气体来降低各种氧化膜(例如TiO2和ZnO)的成膜温度。今后将继续推进其他氧化膜的成膜验证,扩大OER成膜技术的适用范围。
联系我们
第一时间了解我们的新产品发布和最新的资讯文章。 北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企...
北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企... 您有什么问题或要求吗?
点击下面,我们很乐意提供帮助。 联系我们